COB封裝就是將芯片直接貼裝到光源的基板上,使用時
COB光源與熱沉直接相連,無需進行SMT表面組裝。SMD封裝則先將芯片貼裝在支架上成為一個器件,使用時需將器件貼裝到基板上再與熱沉連接。兩者的熱阻結構示意圖如圖1所示,相對于SMD器件,COB熱阻比SMD在使用時少了支架層熱阻與焊料層熱阻,芯片的熱量更容易傳遞到熱沉。COB2)采用ASM的焊線設備將晶片11與基板12過導電線13進行電性連接,使晶片11與基板12上的電路實現導通,焊接完成后,對產品進行檢測,不合格的產品重新返修,合格的產品轉入下一道工序;3)在基板12上設置第一層圍壩14,晶片11及導電線13處于第一層圍壩14所包圍的區域內,將設置好第一層圍壩14的基板12放進烤箱進行烘烤,待第一層圍壩14固化后取出COB

COB主要是應用于商業照明領域,如軌道射燈、天花燈、MR16、GU10等燈具中,并成功解決了兩方面問題:一、
COB光源由于熱量集中帶來的散熱問題,通過結構的設計保證了散熱的通暢,確保了
COB光源在工作期間結溫在安全值以下;二、采用鱗甲結構的反光杯或透鏡結構,解決了燈具光斑的色均勻性。這兩個方面的技術突破,使得國星光電COB燈具壽命及光品質有保證。。當然,亦可以采用自然固化的方法使第一層圍壩14固化;在第一層圍壩14上設置第二層圍壩15,將設置好第二層圍壩15的基板12放進烤箱進行烘烤,待第二層圍壩15固化后取出,亦可以采用自然固化的方法使第二層圍壩15固化,此時第一層圍壩14以及第二層圍壩15形成整體式的整體圍壩。根據實際需要,可在第二層圍壩15上設置繼續設置圍壩,這樣形成整體圍壩的層數更多,使得整體圍壩的高度更高,設置圍壩的目的是為了后面的封膠做準備,而設置多層的整體圍壩是為了增加圍壩的高度,亦可用其他方法增加圍壩的高度,如優化圍壩設備等;
LEDCOB倒裝芯片和COB正裝芯片,為了避免COB正裝芯片中因電極擠占發光面積從而影響發光效率,芯片研發人員設計了倒裝結構,即把COB正裝芯片倒置,使發光層激發出的光直接從電極的另一面發出(襯底最終被剝去,COB芯片材料是透明的)。
表1:溫度測量方法對比熱電偶成本低廉,在測溫領域中最為廣泛,探頭的體積越小,對溫度越靈敏,IEC60598要求熱電偶探頭涂上高反射材料減少光對溫度測量的影響。但如果將熱電偶直接貼在發光面上進行測量,探頭吸光轉換成熱的效果十分明顯,會導致測量值偏高。
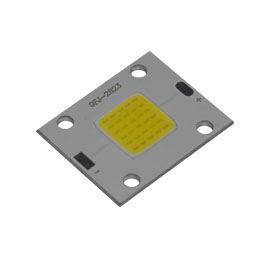
COB同時尺寸不統一,加工需求、客戶需求不一樣,導致市場量產難度加大。COB裸芯片技術主要有兩種形式:一種COB技術,另一種是倒裝片技術(FlipChip)。板上芯片封裝(COB),半導體芯片交接貼裝在印刷線路板上,芯片與基板的電氣連接用引線縫合方法實現,并用樹脂覆蓋以確保可靠性。